收藏 | 史上最全失效分析指南:PCB、金属、高分子检测方法汇总
收藏 | 史上最全失效分析指南:PCB、金属、高分子检测方法汇总

失效分析简介
在现代工业体系中,从纳米级的芯片到万吨级的轮机,任何材料的早期失效都可能引发安全风险与经济重创。失效分析是一门融合了材料学、物理学、化学和机械工程学的交叉学科,它不仅是“验尸官”,更是产品迭代的“诊断医生”。
它的核心任务是:通过观察失效现象,利用物理和化学手段复现失效过程,挖掘失效根因与机理。无论是军工航天的高可靠性要求,还是普通消费电子的成本控制与寿命提升,失效分析都贯穿了设计、试产、量产、售后的全生命周期。

失效分析流程
标准的失效分析遵循一套严谨的逻辑闭环,而非盲目测试。以下是通用的失效分析流程逻辑图:
背景调查与失效现象确认 → 无损观察与电性能初测 → 定位失效点与故障复现 → 制样与微观形貌分析 → 成分与结构表征 → 模拟验证实验 → 根因推断与报告输出 → 改进措施建议

一、 PCB/PCBA失效分析
PCB 作为电子元器件的电气连接载体和支撑体,其质量直接决定终端设备的可靠性。随着无铅焊接和密集组装技术的发展,PCBA 的失效模式愈发复杂。

1、常见失效模式
爆板分层、CAF(导电阳极丝)迁移、焊点开裂(IMC层过厚/脆裂)、电化学腐蚀、短路烧毁、BGA 枕头效应等。

2、核心检测手段一览
2.1、无损透视定位:
X-ray 透视与 3D X-ray (CT):检查 BGA 焊球空洞、IC 内部键合线断裂、PCB 内层开路。
超声波扫描显微镜 (C-SAM):分层与裂纹的克星。通过超声波反射差异,无损检测塑封器件内部、PCB 基材、散热底板的分层、空洞和裂纹。

2.2、微观形貌与元素分析:
SEM + EDS (扫描电镜与能谱):观察焊点断裂微观形貌(韧窝/解理),分析腐蚀产物元素构成(如硫、氯)。
FTIR (显微红外):分析 PCB 表面残留的助焊剂或污染物有机物成分。

2.3、热学与电学分析:
TMA (热机械分析):评估 PCB Z 轴热膨胀系数(CTE)是否匹配,防止爆板。
绝缘电阻测试 (SIR):评估线路间的抗电迁移能力。
二、 电子元器件失效分析
从简单的电阻电容到复杂的 CPU/GPU,元器件的失效往往是整机故障的源头。分析难点在于芯片尺寸极小,往往需要微米甚至纳米级的解剖。

1、常见失效模式
EOS (电气过应力烧毁)、ESD (静电击穿)、栅氧层漏电、金属化电迁移、键合线疲劳断裂、芯片开裂。
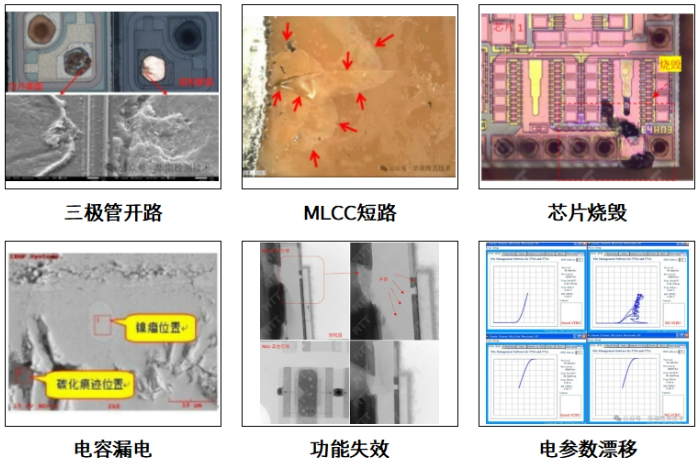
2、核心检测手段一览
2.1、无损扫描:
C-SAM:检查封装内部 Die Face (芯片表面) 或 Lead Frame (引线框架) 的分层,这是潮敏失效的首要检测步骤。

2.2、芯片开封与制样 (核心步骤):
化学/激光/等离子开封:在不损伤内部芯片和金线的前提下,移除塑封料外壳。
FIB (聚焦离子束):芯片级的“手术刀”,用于特定晶体管的截面切割与电路修补,配合 SEM 观察栅极结构缺陷。
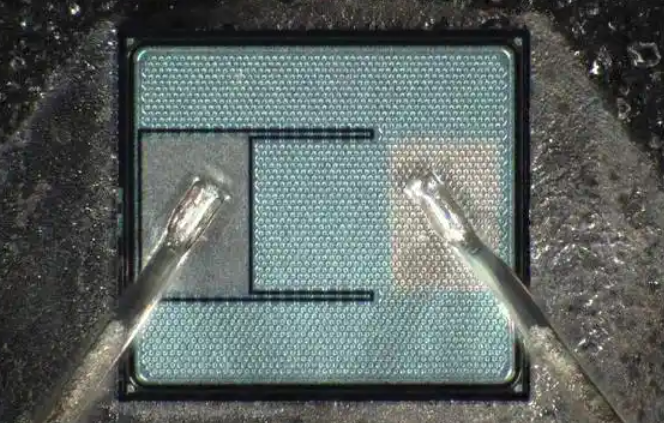
2.3、热点定位:
Thermal Emission / OBIRCH (光热阻扫描):在电性能异常时,快速定位芯片内部的短路漏电热点位置。

2.4、表面微分析:
AES (俄歇电子能谱):分析纳米级厚度的钝化层氧化或污染问题。

三、 金属材料与构件失效分析
金属失效往往涉及巨大的机械能和断裂力学问题,是大型装备事故调查的核心。

1、常见失效模式
疲劳断裂 (高周/低周)、应力腐蚀开裂 (SCC)、氢脆、过载断裂、磨损、高温蠕变。

2、核心检测手段一览
2.1、断口分析 (金相与显微):
体式显微镜 + SEM:宏观判断断裂源区,微观寻找疲劳辉纹 (疲劳断裂的铁证) 或沿晶断口 (应力腐蚀/氢脆特征)。

2.2、金相组织与物相:
金相显微镜:检查材料基体组织是否正常 (如是否存在网状碳化物、晶粒粗大)。
XRD (X射线衍射):分析断口腐蚀产物的化合物类型,或测量残余奥氏体含量。

2.3、力学与残余应力:
显微硬度计、万能试验机:验证材料力学性能是否达标。
X射线应力仪:检测加工或热处理引入的有害残余应力。
四、 高分子材料 (塑料/橡胶/胶粘剂) 失效分析
高分子材料具有粘弹性,其失效受温度、氧气、光照、溶剂等多重因素影响,化学降解往往是主要原因。

1、常见失效模式
环境应力开裂 (ESC)、热氧老化变脆、水解降解、增塑剂析出、疲劳龟裂。

2、核心检测手段一览
2.1、成分与化学结构 (重中之重):
FTIR / Raman (红外/拉曼):鉴别材料牌号基础配方,并对比失效部位与正常部位是否发生氧化 (出现羰基峰) 或水解。
GC-MS (气相质谱联用):通过热裂解或溶剂萃取,分析配方中的微量添加剂、增塑剂或污染物。
GPC (凝胶渗透色谱):测定高分子分子量及分布。若分子量骤降,说明材料发生了严重的断链降解。
2.2、热性能与力学:
DSC (差示扫描量热):检查材料玻璃化转变温度 (Tg)、熔点、结晶度是否异常。
TGA (热重分析):分析材料中炭黑、碳酸钙等填料的真实含量,或评估热稳定性。
五、 复合材料与涂层/镀层失效分析
复合材料的失效往往发生在界面;涂层失效则涉及基材与膜层的结合力。

1、核心检测手段一览
1.1、界面结合力:
划格法/拉拔法:定量测试涂层附着力。
SEM 截面分析:通过离子研磨 (CP) 制备无应力损伤的截面,观察涂层与基材界面是否存在柯肯达尔空洞或富集层。
1.2、成分纵深分析:
XPS (X射线光电子能谱):分析镀层表面极其浅层 (1-10nm) 的化学价态,判断氧化程度。
GD-OES (辉光放电光谱):快速分析镀层从表面到基材的纵深元素分布梯度。
六、 核心仪器分析方法深度解析 (收藏级)
1、成分分析利器

2. 热分析四大天王
TGA (热重):看重量变化。定量分析水分、残炭、分解温度。
DSC (差示扫描):看热量变化。测Tg、熔点、固化度、氧化诱导期(OIT)。
TMA (静态热机械):看尺寸变化。测热膨胀系数、软化点。
DMA (动态热机械):看模量变化。比DSC灵敏10倍的Tg测试,研究粘弹性。

结语:失效分析的“体检”与“验尸”
失效分析工程师如同工业界的医生。
在研发阶段,我们是做“产前筛查”,找出设计薄弱点;
在量产阶段,我们是做“定期体检”,监控工艺波动与批次可靠性;
在客诉发生时,我们是做“病理尸检”,通过X光 (CT/C-SAM) 看透内部,抽血验成分 (FTIR/GC-MS),活检看细胞 (SEM),
最终开具药方。
目前,高端制造业的竞争已从单纯的功能实现转向可靠性与寿命预测的竞争。只有将失效分析的DNA注入到产品设计的前端,才能真正做到防患于未然,从根本上提升中国制造的品质口碑。
本文内容基于公开专业资料整理,仅供参考,具体分析需结合实际工况由专业实验室操作。
声明:本篇文章是广东省华南检测技术有限公司「www.gdhnjc.com」原创,转载请注明出处。
热门资讯 
最新资讯 
- 收藏 | 史上最全失效分析指南:PCB、金属、高分子检测方法汇总
- PCB切片分析:揭秘电路板内部质量的利器
- 塑料产品CT扫描:工业无损检测的革命性技术
- 工业CT三维重建技术全解析:从断层扫描到高精度3D模型的内部透视逻辑
- PCBA失效分析怎么做?第三方机构详解7步标准流程
- 工业CT缺陷检测:气孔裂纹夹杂一次看清
- PCBA失效分析 | 二极管焊点疲劳开裂案例拆解
- 工业CT扫描多少钱一次?深度解析2026年检测费用标准与影响因素
- 工业CT无损检测原理详解:从X射线到三维重建
- 工业CT无损检测费用公开:按小时还是按件?岛津225KV设备实测,这样计费更划算!
- 热重分析测试怎么做才准?TGA Q500实测案例告诉你答案
- 贴片电容失效分析:3大常见击穿原因及真实案例解读
- 工业CT检测在制造业中的应用
- TGA热重分析测试:材料热稳定性与成分分析指南
- 工业CT检测如何提高产品质量?一个真实案例告诉你答案
- 芯片BGA不良失效分析:从焊点开裂到识别不到设备的全面解析
- 工业CT扫描在逆向三维建模中的高精度应用
- 从工业CT到三维分析:工业CT无损检测如何赋能产品研发与失效分析?
- PTC电阻变大导致充电故障?专业失效分析揭秘根本原因
- 工业CT扫描在孔隙率检测中的应用:精准量化,提升工艺






