EOS和ESD失效分析
在大多数的失效分析案例中电子子元件内部电路与地(GND)或不同電位贴之简形成短路,产生过点流而造成原件损坏为大多数电子元件失效的主要因素。静电可以定义为累积在材料表面的固定电荷。静电荷之间的相互作用(称为静电)导致两个关键问题:静电过应力(EOS)和静电放电(ESD)。
通常,ESD会导致半导体行业中超过三分之一的现场故障。ESD引起的半导体故障可以通过泄漏,短路,烧毁,接触损坏,栅极氧化物破裂以及电阻器-金属界面损坏的形式看到。EOS是一个术语,用于描述当IC承受超过器件数据手册规格限制的电流或电压时可能发生的热损坏。EOS事件可能会使IC降级或导致永久性功能故障。EOS比ESD慢得多,但是相关能量很高。
热损坏是EOS事件期间产生的过多热量的结果。EOS事件中的高电流会在低电阻路径中产生局部高温。高温会损坏器件材料,例如栅极氧化物和互连,导致金属烧坏。由于EOS和ESD故障模式的相似性,EOS和ESD通常归类为单项故障机制,即“ ESD和EOS”。
关于应力事件,ESD和EOS相似,但电流或电压以及时间应力条件不同。ESD是一个非常高的电压(> 500 V)和中等的峰值电流(?1 A至10 A)事件,在短时间内发生。EOS是发生在较长时间范围内的低电压(<100 V)和大峰值电流(> 10 A)事件。如果长时间持续,闩锁也会导致EOS损坏。
静电放电
ESD是两个物体之间通过直接接触或感应电场以不同的静电势瞬时释放静电荷的过程。这是带静电的物体的结果。通过IC释放静电荷会产生大电流并耗散能量,从而损坏IC。任何材料表面的电荷通常是中性的。当能量传递给它时,会发生电荷不平衡。
由于导电表面中的高电子迁移率,导体不易通过摩擦来充电,因此会发生电荷复合并保留中性表面。另一方面,绝缘子可以容易地通过摩擦来充电。将能量传递给不导电的材料会导致大量的局部堆积电荷,直到它通过外部路径放电为止。静电的主要来源包括绝缘体,例如塑料表面,绝缘鞋,木质材料和气泡包装。由于绝缘体中的电荷分布不均匀,这些源所产生的电压电平可能会很高,达到总计千伏。
IC中的ESD损坏也可能来自热现象。局部体积中会以非常快的速率产生大量热量,而这太快了,无法去除。因此,IC会以金属互连烧坏,多晶硅损坏,栅氧化层破裂或击穿,接触尖峰或结击穿的形式损坏。
当人们在合成地板上行走时,它们可以累积高达20 kV的电压。在干燥的空气中摩擦(摩擦)尼龙和聚酯可产生25 kV。当人触摸接地物体时,电荷会在很短的时间内(1到100 ns)从人移动到物体。放电时间和电流取决于时间常数。
放电电流总计约为1 A至10A。从工厂到现场的任何地方都可能对电子设备造成静电损坏。半导体器件设计用于ESD保护,可在短时间内承受高电流。
例如,如果某个设备符合ESD-HBM的规定,可以承受2kV的指定电压,则该设备可以以1.3ns的上升时间和10ns的下降时间承载1.3A电流。但是,该同一设备在几毫秒内无法传输100 mA的电流。如果设备暴露于弱ESD脉冲中并受到部分损坏,则它可能会继续发挥足够的作用,并通过符合数据表规格的生产自动化测试设备(ATE)测试。
然后,该缺陷可能会随着时间的流逝而扩展,并且几个小时后设备就会发生故障。这些类型的缺陷称为潜在缺陷,而故障称为潜在的ESD故障。潜在缺陷很难检测到,尤其是在将设备组装成最终产品之后。从概念上讲,ESD(Electro-Static discharge),静电释放,EOS (Electrical Over Stress),电气过应力。广义上讲ESD也属于EOS,为了便于分析,这里将静电导致的应力失效认为是ESD失效,其余电气应力失效认为是EOS失效。
有统计表明,ESD和EOS失效比例分别占3%和97%。
ESD是两种材料互相位移,导致静电释放,ESD事件需要满足下列条件:
(1)大电压,>500V,峰值电流不高;(2)低能量,放电曲线是脉冲型,时间作用时间短,小于1μs。
ESD失效通常在显微镜下能观测到穿孔,如下图:
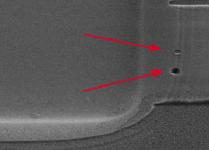
EOS失效是在EOS事件发生后,由于过热导致芯片失效。过热是芯片内部连接电阻发热的结果。在低电阻路径中,在EOS事件期间经历的高电流会产生局部的高温,从而对芯片结构造成破坏性损坏。
EOS事件需要满足下列条件:(1)低电压,<100V,峰值电流高;(2)高能量,事件作用时间通常大于1ms。
EOS失效显微镜下观测如下:
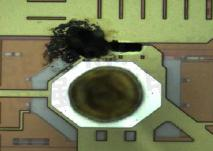
ESD防护方法:
(1)做好接地,在生产过程中注意带防静电手腕及工作表面接地;
(2)芯片在储存或运输过程中,用静电屏蔽袋作为保护;
(3)芯片焊接时,尽量使用离子风机,离子气枪;
(4)PCB增加保护器件。
治理EOS事件时,首先需要明白多数EOS事件最终并未得到解决。EOS关键是注意芯片规格书的极值范围,治理方法可以通过下列:
(1) 测试设备有无接地不良;
(2) 接地回路电流是否过大;
(3) 是否存在高电感/电容负载;
(4) 是否存在交流电源线浪涌(大开关电流);
(5) 是否将长电缆连接到有源电路。
华南检测实验室专注于工业CT检测\失效分析\材料检测分析的先进制造实验室,设立了无损检测、材料分析、化学分析、物理分析、切片与金相测试,环境可靠性测试等众多实验室,为您提供—站式材料检测,失效分析及检测报告,如有需求拨打:13926867016(微信同号)。
热门资讯 
最新资讯 
- 工业CT检测:微米级高精度无损检测服务
- 破坏性物理分析(DPA)检测服务
- 芯片ESD测试全解析:原理、方法、流程与等级标准详解
- 芯片失效分析实战指南:精准定位失效根源,护航国产芯片良率提升
- 收藏 | 史上最全失效分析指南:PCB、金属、高分子检测方法汇总
- PCB切片分析:揭秘电路板内部质量的利器
- 塑料产品CT扫描:工业无损检测的革命性技术
- 工业CT三维重建技术全解析:从断层扫描到高精度3D模型的内部透视逻辑
- PCBA失效分析怎么做?第三方机构详解7步标准流程
- 工业CT缺陷检测:气孔裂纹夹杂一次看清
- PCBA失效分析 | 二极管焊点疲劳开裂案例拆解
- 工业CT扫描多少钱一次?深度解析2026年检测费用标准与影响因素
- 工业CT无损检测原理详解:从X射线到三维重建
- 工业CT无损检测费用公开:按小时还是按件?岛津225KV设备实测,这样计费更划算!
- 热重分析测试怎么做才准?TGA Q500实测案例告诉你答案
- 贴片电容失效分析:3大常见击穿原因及真实案例解读
- 工业CT检测在制造业中的应用
- TGA热重分析测试:材料热稳定性与成分分析指南
- 工业CT检测如何提高产品质量?一个真实案例告诉你答案
- 芯片BGA不良失效分析:从焊点开裂到识别不到设备的全面解析






